400-8800-268
一、背景介紹
BGA的全稱是Ball Grid Array(焊球陣列封裝),它是一種高密度表面裝配封裝技術。在這種封裝方式中,封裝體基板的底部制作有陣列錫球,這些錫球作為電路的I/O端與印刷線路板(PCB)互接。BGA技術是半導體行業封裝的重要形式之一,用于封裝各種集成電路芯片,如CPU、GPU、FPGA、ASIC等。這些芯片在電子設備中扮演著核心角色,因此BGA封裝技術的性能和質量對整個電子產品的性能和可靠性至關重要。而其中,BGA錫球尺寸的測量是半導體封裝工藝中的一個重要環節,其準確性直接影響到封裝的性能和可靠性,BGA錫球尺寸的測量主要包括錫球的高度、平面度、位置度等關鍵指標,這些指標對于確保錫球頂端及間距的精確性至關重要,從而保證封裝后的芯片能夠穩定、高效地工作。
二、配置方案
思瑞OPTIV ADVANCE系列高精度通用型影像測量儀,結構穩定,搭載設計可靠的 3D 復合式測量系統,機身采用高穩定性固定橋式結構,整機采用花崗巖框架,穩定性好,三軸均為中央驅動,采用直線導軌,保證了傳動的精密性。同時搭配LMI 2512 線激光實現平面度測量。

三、檢測流程
1.在影像模式下,用外框邊定位建坐標系。
2.工件球體排列均勻,采用21*2陣列測量球體并求出其位置度。
3.切換至線激光模式,分兩次進行點云掃描。
4.軟件進行影像定位球中心,點云指定點提取Z方向最高點求其平面度。
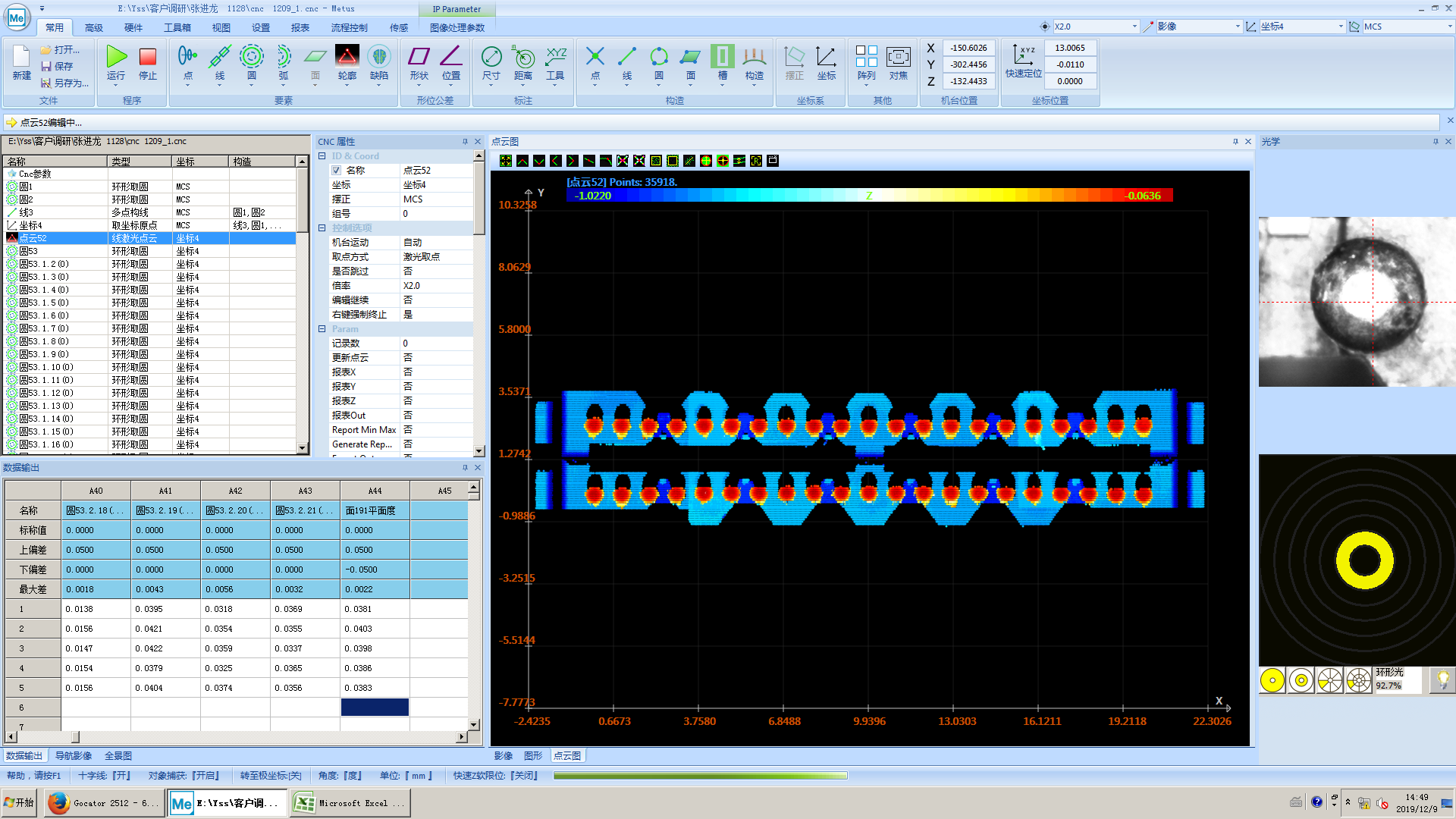
四、檢測思路
1.在進行BGA位置度測量之前,需要確保BGA芯片處于良好的狀態,沒有受到污染或損壞。
2.由于BGA焊點的尺寸較小且分布密集,陣列的偏移值需精準計算。
3.用LMI激光掃描點云,得出每個球體的最高點求出平面度,掃描易有雜點,數值會有突跳,編程時需注意取點方式。
 返回頂部
返回頂部